
|
 |
 |
 page précédente |
vue d'ensemble |
page suivante
page précédente |
vue d'ensemble |
page suivante

01 |
02 |
03 |
04 |
05 |
06 |
07 |
08 |
09 |
10 |
11 |
12 |
13 |
14 |
15 |
16 |
17 |
18 |
19 |
20 |
21 |
22 |
23 |
24 |
25 |
26 |
27 |
28 |
17 – Fermeture des trous
La fermeture des trous métallisés empêche la pénétration de la soudure pendant le processus de soudage et permet le contrôle à l'aide d'un adaptateur sous vide. La fermeture des trous peut se faire des manières suivantes:
• Recouvrement avec le vernis épargne
• Remplissage des trous (viafilling)
• Surmétallisation des vias
• Injection de pâte dans les trous (plugging)
17.1 – Recouvrement avec le vernis épargne
Lors du processus de fabrication, les trous sont recouverts de vernis épargne. Cette couverture est aléatoire. Inconvénient de cette méthode: Les trous ne sont pas fermés à 100 %. En durcissant le vernis épargne se rétracte et peut se fendre. Les trous ne sont donc pas étanches au vide. L’humidité et les résidus chimiques enfermés peuvent poser des problèmes de corrosion, de soudage et de finition. Malgré cela, ce processus est souvent appliqué pour les connexions des composants BGA. En conséquence, le recouvrement avec du vernis épargne sur une face ou sur les deux faces n'est pas recommandable.
La meilleure solution est d'arrêté le vernis épargne avant ou sur le bord de la pastille de cuivre. Pour ce faire, il faut que l'ouverture du vernis épargne soit 0,1 mm > que la pastille ou 0,15 mm > le via.
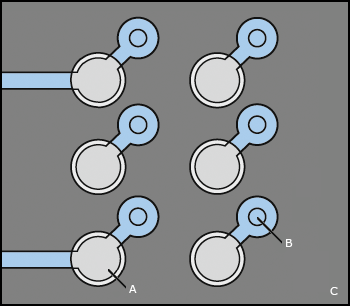
Fig.1: Disposition des pastilles et des trous métallisés des BGA (pads et vias séparés). Les trous sont écartés à 45° des pastilles et recouverts de vernis épargne (Dog Bone Technology). |
 |
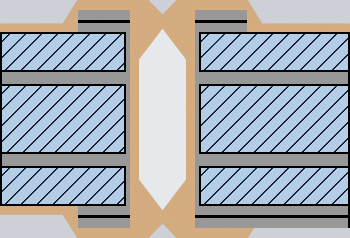
Fig.2: Trou fermé avec le vernis épargne
A Pastilles SMD (pad)
B Trous métalisés (via)
C Vernis épargne |
17.2 – Remplissage des trous (viafilling)
L’étanchéité au vide des trous métallisés est obtenue par pressurisation d’un vernis de remplissage à 1 ou 2 composants. Pour les petits trous le vernis épargne suffit. Un film supplémentaire (fichier Gerber) doit être créé pour cette opération sur les gros trous. Cela empêche l’étain de pénétrer dans les trous lors du soudage et permet le contrôle à l'aide de l'adapteur sous vide.
Cette méthode ne convient cependant pas pour fermer des trous dans la pastille car on ne peut pas souder dessus.
Fig.3: Remplissage des trous métallisés |
 |
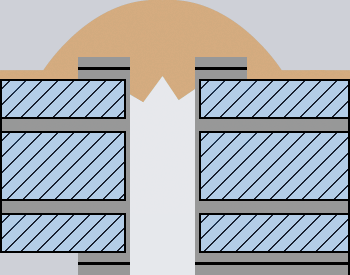 |
17.3 – Surmétallisation des trous
Quand on a des trous de petits diamètres, il est également possible de les "surmétalliser". Cette opération prend cependant beaucoup de temps.
17.4 –Injection de pâte dans les vias (plugging)
Le type de plugging va dépendre du type de pastille, soudable (HPL = Hole Plugged Land) ou non soudable (HP = Hole Plugging). Pour gagner de la place, les pastilles souda-bles (HPL) sont perforées. Après la métallisation des trous pour assurer le contact entre les différentes couches internes et externes, une couche de cuivre est déposée sur l’ensemble du circuit et de la pâte est pressée dans les trous. Lorsque celle-ci a durci, elle est meulée jusqu’au cuivre pour obtenir une surface plane et soudable. Cette opération enlève quelques µm de cuivre.
Ensuite les pastilles non soudables (HL) sont perforées et les trous sont métallisés. Pendant la métallisation une seconde couche de cuivre est déposée sur tout le circuit et les trous sont remplis.
Le circuit imprimé est gravé lorsque toutes ces opérations sont terminées.
Ce procédé est cependant problématique pour les vias borgnes, car de l’air peut être enfermé lors de l’application de la pâte, ce qui peut conduire à des délaminations pendant l’opération de soudure.
Succession des opérations
1 – Circuit imprimé perforé et métallisé
 |
 |
2 – Trous remplis avec de la pâte
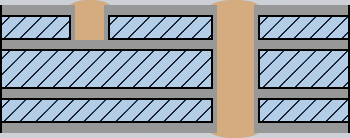 |
3 – Surface meulée
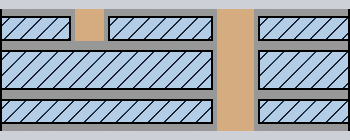 |
 |
4 – Surcharge de cuivre
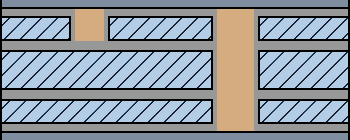 |
5 – Gravage
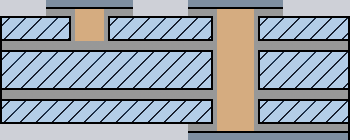 |
 |
6 – Pose du vernis épargne, finition du circuit
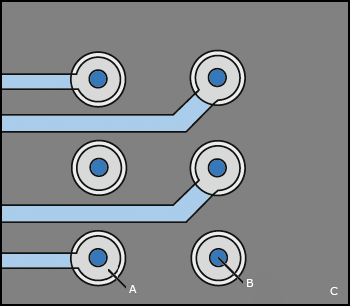
Le gain de place est évident quand on compare à la technique "dog bone".
A Pastilles SMD (pad)
B Trous métalisés (via)
C Vernis épargne |
17.5 – Aperçu des avantages et des inconvénients
A – Recouvrement avec le vernis épargne
Avantages
• Pas de coûts supplémentaires
• Surface plane
Inconvénients
• Etanchéité au vide non garantie
• S’applique uniquement aux petits diamètres
• Pas ou peu fiable
• Risque d’enfermer de l’humidité et des résidus chimiques
Conseil: Pose du vernis épargne uniquement sur la couronne des pastilles soudables
C – Surmétallisation
Avantages
• Vias étanches au vide
• Pastilles soudables (conductrices)
• Pastilles perforées possibles
Inconvénients
• Onéreux (prend beaucoup de temps)
• Surface pas plane
Paramètres:
• Epaisseur des circuits max. 1,0 mm
• Diamètre des vias max. 0,3 mm
• Aspect ratio max. 1:5 |
 |
B – Remplissage des trous
Avantages
• Plus économique
• Fermeture étanche au vide
Inconvénients
• Ne se prête pas aux pastilles perforées
• Surface pas plane
• Pas applicable si largeur de piste est < 0,15 mm
Paramètres: Diamètre des trous maximum 0,5 mm
Alternative: Plugging sans surcharge de cuivre
D – Plugging (HPL)
Avantages
• Pastilles perforées possibles
• Gain de place sur les circuits
• Surface fermée et plane
Inconvénients
• Onéreux, plusieurs opérations
• Epaisseur de cuivre irrégulière due au meulage. Cela peut engendrer
des problèmes de gravure des circuits (spécialement avec largeurs
de piste < 0,15 mm)
• Problème de plugging des trous borgnes
Paramètres:
• Diamètre de vias min. Ø 0,2 mm / max. Ø 0,5 mm
• Largeur/distance min. entre les pistes >125 µm
• Aspect ratio max. 1:8 |
|
 |


